|
設計一款功率轉換器并不簡單,因為其中涉及多方面的技術知識。出色的功率轉換器設計工程師必須對模擬及混合信號電路的設計、變壓器繞組、電磁兼容性、封裝及散熱設計有一定的認識。由于電子產品的功率密度越來越大,加上不同的電源供應系統設計各有優缺點,因此工程師必須審慎考量,作出最適當的取舍,才可確保所采用的封裝及散熱設計能夠滿足電源管理系統的要求。部分電子產品需要傳送大量數據,令系統結構越趨復雜,因此散熱系統的設計越來越受到高度的關注。
稱為“磚塊”的模塊式直流/直流轉換器在上一世紀的八十年代中期正式面世,自此以后,這方面的技術發展非常迅速。以十六分之一 磚塊的結構設計為例來說, 1.2 平方英吋的印刷電路板板面空間可轉換功率高達 33W 至 50W。
電信系統總線可以在 36V 至 72V 的電壓范圍內操作,這個電壓范圍比容差較小的數據通信系統總線更為廣闊。總線轉換器負責在總線上進行功率轉換,其中的每一張子卡都互相分隔開。轉換器采用這種磚塊格局尚屬首次,但磚塊結構有它的優點,因為子卡上的供電可直接輸入負載電路。近年來數字信號處理器及數字特殊應用集成電路大受歡迎,因此中間總線結構便應運而生。這種結構的優點是總線轉換器可以提供隔離的 12V 至 14V 供電,而卡上負載的點負載穩壓器則負責進一步的功率轉換。
設計電源供應器的工程師一旦為應用系統選定電路布局之后,便要面對以下的問題:究竟需要多少功率轉換級 1 ?轉換器究竟應采用硬開關還是軟開關?由于這兩個問題的關系,選用哪一類開關及整流器便顯得極為重要。大部分磚塊式轉換器都采用功率 MOSFET 組建電源開關及低電壓同步整流器。經過多年的發展,MOSFET 技術已相當成熟,現在系統設計工程師甚至可以選用具有標準導通狀態電阻 (RDS-ON) 的溝道型芯片及極間電容較低的平面型芯片。電壓及電流的額定值一旦確定之后,選用哪一類芯片便要視乎芯片的最大損耗究竟來自開關速度還是來自導通狀態電阻?近來,CDG / CGS 比率受到系統設計工程師高度的重視,因為這個比率是顯示高功率、高頻率的半橋式功率轉換級會否出現射穿情況的指標。
開關頻率及電磁干擾之間的適當平衡
好的功率轉換器除了要有較高的開關頻率之外,也要顧及系統的轉換效率及電磁干擾。換言之,各方面都要兼顧,力求取得適當的平衡。開關頻率越高,電源開關、整流器及控制電路的開關損耗便會越高。以模塊式直流/直流轉換器來說,只要提高開關頻率便可采用較小的濾波器及能源儲存元件,這是提高開關頻率的好處。但以采用硬開關的系統來說,電源管理芯片的高頻信號會出現較多諧波,令芯片與散熱器或供電層之間的雜散電容出現大量位移電流。這些位移電流甚至會流入變壓器的線圈電容,最后甚至會造成共模干擾。
以采用直流/直流轉換器的控制及驅動系統來說,工程師設計集成電路及其封裝時,已考慮到磚塊轉換器的結構而作出適當的調節。以電路的設計來說,更高的技術集成度、板上高電壓穩壓器、更高時鐘頻率以及可編程壓擺率的低射穿驅動器都適合新一代的設計采用 2。散熱是設計電源管理集成電路需要面對的主要問題。電源管理集成電路內置的驅動器、穩壓器通道晶體管以及電源開關都設于裸片的外圍,緊貼焊盤。這些內置芯片及晶體管進行操作時,熱能會傳遍整顆裸片,形成一幅由不同等溫線組成的熱能“分布圖”。若不同的晶體管分別設于不同的等溫線之上,部分次電路 (尤其是溫度必須相匹配的差分電路) 便會在性能上受到影響。集成電路的線路布局必須作出調整,例如芯片正常操作時,不同晶體管在同一時間內都處于相同的溫度之下,但要取得這樣的效果并不容易。電源管理集成電路的縮微圖顯示部分芯片經常采用交叉耦合的設計,以便可以在初期階段減少熱能的耗散量。

圖1:LLP 封裝的正面及反面
圖 1 顯示的無引線導線封裝 (LLPÒ) 是一種有導線的芯片級封裝 (CSP),其優點是可以提高芯片的速度,降低熱阻以及占用較少印刷電路板的板面空間。由于這種封裝具有體積小巧及外型纖薄的優點,因此最適用于設有模塊式直流/直流轉換器、元件較為密集的多層式印刷電路板。
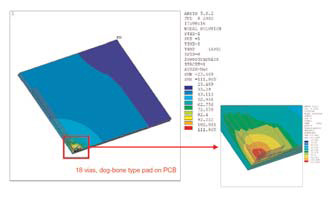
圖2:LLP 封裝的有限接線原理圖 (finite element plot)
LLP 封裝有如下的優點:
· 低熱阻
· 較少寄生電子響應
· 可以充分利用電路板板面空間,以支持更多其他功能
· 封裝更纖薄
· 封裝更輕巧
集成電路的封裝設計過程涉及很多繁復的工序,例如要為散熱及機械系統建立模型,以便進行測試;此外,進入生產及測量階段之后,裸片上的實際測量數字或模擬圖所示的熱能分布數字必須與圖2 所示的有限接線電路模型 (finite element model) 互相比較。一般來說,我們只要針對設于新封裝內的測試裸片,測量其二極管的正向壓降,便可取得裸片的實際測量數字。很多不同的遠程二極管溫度傳感器芯片都采用這種經過長期測試、證實有效的技術,以便能夠為新一代的微處理器、數字信號處理器及數字特殊應用集成電路提供更可靠的防護。我們也可利用測試裸片內置的一個或多個二極管將熱能傳入,以核實裸片的熱特性。
封裝設計及熱特性
芯片封裝有兩種熱特性,分別以 qJA 及 qJC 作為代號表示。按照定義,qJA 是封裝熱阻的總量,亦即封裝內部及外部的熱阻總和,其數值可以利用以下公式計算出來:
qJA = qJC + qCA = (TJ - TA)/P
在以上公式之中:
qJC:(TJ - TC)/P -- 結面至機箱的導熱性熱阻 (°C/W)
qCA:(TC - TA)/P -- 機箱至環境的對流熱阻 (°C/W)
P:I (電流) x V (電壓) -- 芯片的熱量耗散 (W)
TJ:芯片結面的平均溫度 (°C)
TA:環境的平均溫度 (°C)
TC:封裝上某一指定位置的機箱溫度 (°C)
在封裝物料的底層內,qJC 熱阻大部分屬于導熱性熱阻,熱阻大小主要取決于封裝的配置。若熱能流向與封裝的物料層平面成 90 度角,qJC 可以利用以下公式計算出來:
åti/(ki Ai)
在以上公式之中,ti 是指每一封裝物料層的厚度,ki 是指其導熱性,而 Ai 是指導熱面的面積。上述封裝物料包括連接裸片的物料、導線、裸片表層涂料以及模封或封裝絕緣物料。
qCA 是外在環境的對流熱阻,其大小主要由周圍環境、封裝邊緣狀況及共軛熱能傳送等因素決定。以 LLP 封裝來說,結面至周圍環境的熱阻較低,只要降低印刷電路板導熱面至結面的熱阻,便可減少大部分結面至周圍環境的熱阻。圖3 的橫切面顯示裸片焊接在連接裸片的焊盤上,而焊盤則直接焊接在印刷電路板的供電層之上。以采用磚塊轉換器的系統來說,其 qCA 熱阻值主要取決于印刷電路板供電層的面積,因為熱能主要通過導熱的方式散發出去,而傳導成為主要散熱方式的原因是子卡之間的間距越趨縮小,令空氣的對流作用受到限制,無法充分散發熱能。
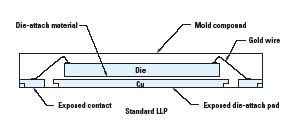
圖3:LLP 封裝的橫切面
不同封裝的比較
芯片底層的供電層只要加設散熱孔,便可改善 qCA 對流熱阻。但我們若將焊接 LLP 封裝的焊接層面積加大,散熱效果會比改善對流熱阻更為顯著。只要將 LLP 封裝與采用相同引腳數目及裸片的傳統式 SO 封裝加以比較,便可顯示 LLP 封裝這方面的優勢。
以 MSOP-8 封裝為例來說,這種封裝占用 15 平方毫米的印刷電路板板面空間,而 LLP-8 封裝所占用的板面空間只有 9 平方毫米。兩者在熱阻方面有很大的差別,LLP-8 封裝的熱阻 (qJC) 只有 40°C/W,而 MSOP-8 的熱阻卻高達 200°C/W。
以下就上文所說作一簡單的總結。對于電源管理集成電路來說,模塊式直流/直流轉換器對周圍環境有極嚴格的要求。照目前的趨勢看,電源系統的功率密度會越來越高,這是不可抗拒的發展規律,而工程師也會更充分利用電路板的板面空間。面對這個發展趨勢,設計電源管理集成電路及芯片封裝的工程師便不得不進一步改善熱阻及板面空間的使用效益,并且在這個精益求精的過程中不斷為業界創立新的標準。我們倡議業界采納新標準時,必須向電源供應系統設計工程師詳加解釋,讓他們對封裝設計、測量及驗證過程有一定的了解。由于新一代的分立式電源管理芯片非常受歡迎,因此工程師尤其是要對電源管理技術有一定的認識。 |